随着高性能计算与大数据存储需求的持续攀升,开发具备高密度、高速度和高可靠性的存储技术,已成为当前半导体产业发展的重要突破口,而存储器介质材料的创新与研发正展现出日益突出的战略价值。其中,HfO₂基薄膜作为一种关键介质材料,不仅在传统动态随机存储器(DRAM)中作为高介电电容器材料实现成功应用,更因其独特的铁电性能,成为新型铁电存储器(FeRAM)中极具潜力的电容器候选材料,其介电与铁电特性正推动其在DRAM、FeRAM、铁电场效应晶体管(FeFET)及铁电隧道结(FTJ)等多种信息存储器件中的广泛应用与深入发展。
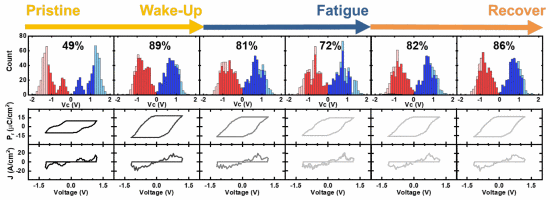
模拟 Vc 分布、P-V 和 J-V 曲线,在循环演化过程中:醒来(3 MV/cm)、疲劳(1.2 MV/cm)和恢复(4 MV/cm)
在算力需求呈指数级增长的时代,铁电存储器因其非易失存储特性和低功耗优势,成为神经形态计算和存内计算架构的可靠选择,其中铪基铁电存储器凭借其与标准互补金属氧化物半导体(CMOS)工艺的完美兼容性以及优异的三维集成能力,展现出卓越的性能潜力。然而,对比传统的铁电器件,铪基铁电器件的可靠性问题尤为突出:其在经历10⁶次读写循环后即出现显著的疲劳效应(可反转极化值逐渐降低),导致读写窗口急剧减小;当操作次数达10⁸次时,薄膜漏电流密度显著增加,进一步导致击穿,严重威胁器件使用寿命。因此,铪基铁电存储器的抗疲劳特性和耐久性等可靠性问题,已成为制约其发展的关键因素。
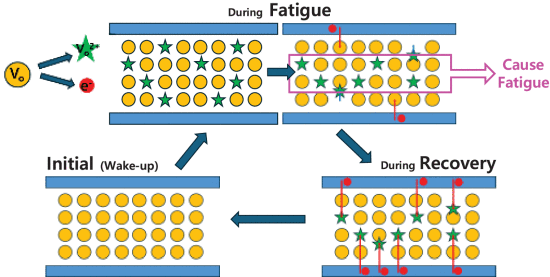
基于 HZO 的铁电电容器中唤醒、疲劳和恢复机制的示意图。箭头表示每次过程后粒子电荷态变化的方向
课题组侧重点与优势
已取得的研究进展
参考文献
- Fei Mo, Takuya Saraya, Toshiro Hiramoto, and Masaharu Kobayashi, “Reliability characteristics of metal/ferroelectric-HfO2/IGZO/metal capacitor for non-volatile memory application,” Appl. Phys. Express 13, 074005 (2020). https://doi.org/10.35848/1882-0786/ab9a92
- U. Celano et al., “Probing the Evolution of Electrically Active Defects in Doped Ferroelectric HfO2 during Wake-Up and Fatigue,” 2020 IEEE Symposium on VLSI Technology, Honolulu, HI, USA, 2020, pp. 1-2, doi: 10.1109/VLSITechnology18217.2020.9265098.
- C. -Y. Cho, T. -Y. Chao, Y. -L. Shih, T. -Y. Lin and T. -H. Hou, “Interplay Between Charge Defects and Ferroelectric Reliability: From Wake-Up, Imprint, Fatigue to Breakdown,” 2025 IEEE International Reliability Physics Symposium (IRPS), Monterey, CA, USA, 2025, pp. 1-6, doi: 10.1109/IRPS48204.2025.10983640.
